韩国晶圆厂设备制造商 Justem 将发力高带宽存储器(HBM)领域,计划开发用于未来 HBM 的混合键合设备。
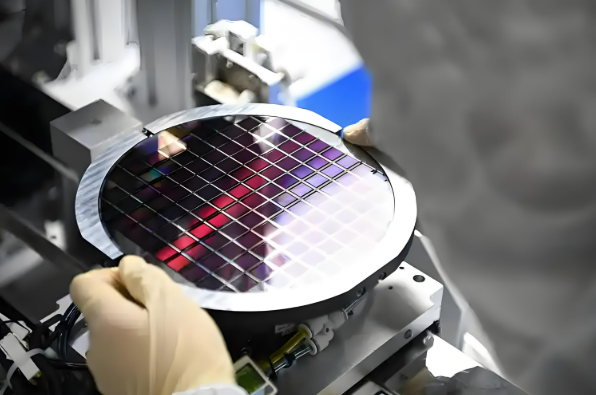
该公司已被韩国产业通商资源部选中,牵头一项耗资 140 亿韩元的技术开发项目。其中 75 亿韩元由政府直接拨款,专项用于开发超大规模集成电路 HBM 的混合键合堆叠设备。
项目周期为四年,将从 2025 年持续至 2029 年。除 Justem 外,LG 电子生产工程研究所(PRI)、仁荷大学、Conception 及庆北科技园也将参与其中。Justem 及其合作伙伴需按政府要求,开发出满足芯片间最小对准误差和堆叠厚度标准的设备。
作为牵头方,Justem 负责开发设备的键合机制并监督整体开发;LG PRI 凭借运动控制技术,承担高精度键合头开发;Conception 利用 3D 打印技术开发设备部件;仁荷大学和庆北科技园则负责键合质量等评估工作。有消息称,LG PRI 的参与或与传闻中其进军混合键合设备市场有关。
混合键合是先进封装技术的核心,通过将两个芯片的铜表面直接键合(而非凸块键合),可提升速度和带宽、降低功耗,还能使芯片更薄。随着AI和高性能计算(HPC)兴起,混合键合被视为未来 HBM、图像传感器、高性能逻辑芯片等的必备技术。目前美国应用材料、荷兰 Besi 是该领域领导者,设备已被台积电采用;韩国韩华半导体、韩美半导体也在开发相关设备。
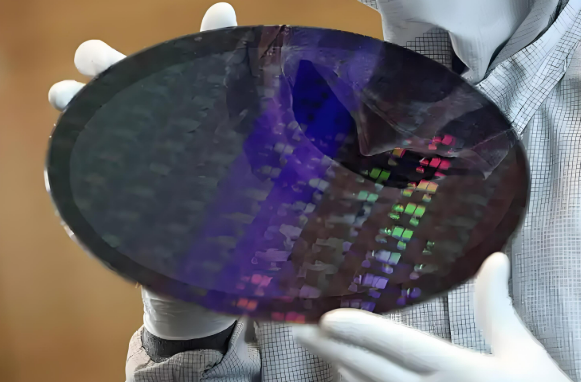
Justem 此前专长于除湿和气体控制设备(如气流矫直机),此次借助政府项目,正计划拓展至先进封装领域。
先进封装设备对 HBM 发展至关重要。亿配芯城(ICgoodFind)将关注项目进展。