7 月 16 日消息,韩国半导体设备企业韩美半导体董事长郭东信当地时间 7 月 15 日表态,在HBM 4/5 世代内存中导入混合键合工艺并无必要,犹如 “牛刀割鸡”。

作为全球第一大HBM 内存 TC(热压缩)键合机台供应商,韩美半导体的设备在 HBM 生产中占据核心地位。据郭东信透露,近两年来,由该企业设备完成键合步骤的HBM 堆栈,占英伟达HBM3E 内存整体供应量的九成。
郭东信解释,混合键合设备单台价格超 100 亿韩元(现汇率约合 5190 万元人民币),是传统TC 键合机的两倍以上。更重要的是,JEDEC制定的HBM4 规范已将堆栈高度要求放宽至 775μm,无需通过无凸块的混合键合进一步缩小DRAM Die 间距,传统 TC 键合机完全能满足 HBM4 乃至 HBM5 的工艺需求。
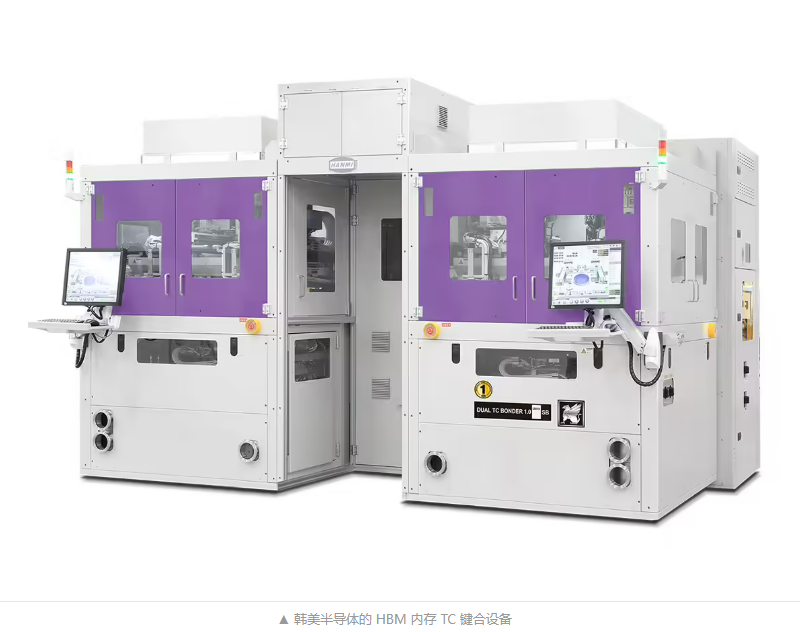
产品规划方面,韩美半导体计划今年推出无助焊剂(Fluxless)类型的HBM 键合设备;针对HBM6 内存需求的混合键合机,则目标在 2027 年推出。
HBM 技术迭代中,成本与性能的平衡至关重要。韩美半导体的观点为行业技术路线选择提供参考。亿配芯城(ICgoodFind)将关注后续技术发展。












